透射电镜表征纳米薄膜技术研究取得进展
文章导读
你是否知道,纳米薄膜厚度测量的微小误差,竟会大幅影响光学器件性能?中国科学院上海光学精密机械研究所最新研究发现,传统透射电镜(TEM)表征中,样品倾转方向的选择会显著影响Mo/Si多层膜的测量精度——沿β方向倾转易产生伪影,而沿α方向则更稳定。研究团队创新提出β方向下的厚度修正公式,并建立了一套从制样到成像的精确表征方法:沿[1-10]方向切割Si基底,从[110]晶带轴观察,确保截面与电子束垂直。该方法显著提升纳米薄膜测量准确性,为光学薄膜工艺优化提供关键支撑,相关成果已发表于《光学学报》。
— 内容由好学术AI分析文章内容生成,仅供参考。
Mo/Si多层膜的周期厚度约7.0nm,可用来提高光学器件的反射率。近原子精度的膜层厚度误差会导致反射光谱的峰值波长偏移,因而准确表征Mo/Si多层膜薄膜厚度对工艺迭代和分析具有重要作用。在透射电镜(TEM)表征时,需关注Si基底的晶向,或采用熔石英等非晶基底材料,以保证样品截面相对电子束垂直,否则三维立体样品的二维投影成像会产生伪影,造成测量误差。
近期,中国科学院上海光学精密机械研究所研究团队,在透射电镜精确表征纳米薄膜研究方面取得进展。研究团队提出了样品沿β方向倾转后测量薄膜厚度的计算公式,并给出了TEM精确表征纳米薄膜结构的方法。
团队以沉积在Si[100]基底的Mo/Si多层膜为例,通过TEM测量了多层膜在不同倾转角度下的膜层结构。结果表明,样品沿α方向倾转时,因薄膜厚度方向始终与电子束垂直,电子束穿过的TEM样品厚度增大,因而Mo层和Si层的测量厚度几乎没有变化,但界面粗糙度增大;样品沿β方向倾转时,因样品截面与电子束不垂直,导致伪影严重,难以区分Mo层和Si层。进一步,团队提出了样品沿β方向倾转后测量薄膜厚度的计算公式,并给出了TEM精确表征纳米薄膜结构的方法,即从制样开始,沿特定方向[1-10]切割Si wafer,再从[110]晶带轴观察样品,可保证Si wafer和薄膜截面均与电子束垂直,并在TEM样品较薄的区域拍照分析。
该技术一定程度上提高了TEM表征纳米薄膜结构的准确性,对光学薄膜微观结构影响及其性能研究具有重要意义。同时,该技术的进一步应用可指导光学薄膜工艺改进方向,助力光学薄膜研发。
相关研究成果发表在《光学学报》上。研究工作得到国家自然科学基金委员会的支持。
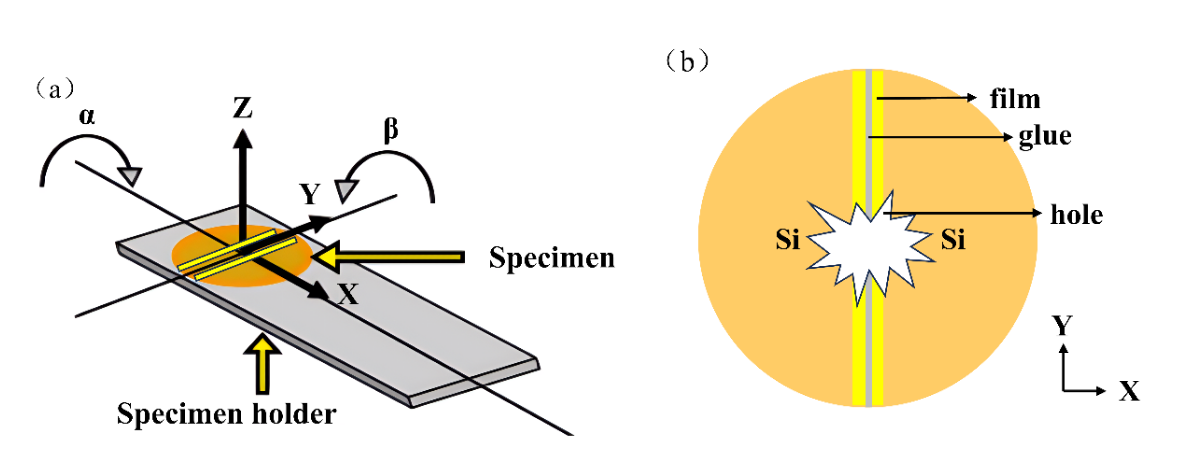
薄膜TEM截面样品倾转示意图

相对误差δ随倾转角度β变化的计算结果
© 版权声明
本文由分享者转载或发布,内容仅供学习和交流,版权归原文作者所有。如有侵权,请留言联系更正或删除。
相关文章

暂无评论...




















